Полевые транзисторы с барьером шоттки
Содержание:
Арсенид галлия ( GaAs ) относится к полупроводниковым химическим соединениям типа A 3 B 5. Его особенности следующие.
У арсенида галлия более широкая, чем у кремния, ширина запрещенной зоны составляющая 1,43 эВ и в 5…6 раз более высокая, чем у кремния подвижность электронов, составляющая 0,8 м 2 /В·с. Более высокая подвижность электронов позволяет снизить уровень легирования областей затворов полевых транзисторов. Снижение барьерных емкостей различных переходов, в свою очередь, приводит к уменьшению времена рассасывания избыточной концентрации носителей заряда и уменьшению времена задержки переключения транзисторов на основе GaAs до 0,1…1 нс.
Кроме того, полевые транзисторы на основе GaAs отличаются меньшим значением температурного коэффициента напряжения α U , T =(0,5…1,5) мВ/К (для кремния этот показатель составляет около 2 мВ/К). Поэтому они имеют лучшую температурную стабильность электрических характеристик.
К достоинствам GaAs относится и то, что радиационная стойкость соединений А 3 В 5 в десятки раз выше, чем у Si .
Недостатком арсенида галлия, как полупроводникового материала является более сложный технологический процесс изготовления транзисторов на его основе.
Полевой транзистор с барьером Шоттки на основе арсенида галлия (ПТШ, МЕП-транзистор) изготавливается методом ионной имплантации донорной примеси элемента 6 группы ( Te , Se , S ) в сверхчистый i — GaAs ( ni ≈2·10 12 м -3 ) с удельным сопротивлением ρ=10 9 …10 11 Ом·м, выращенный в виде эпитаксиальной пленки на подложке полуизолирующего GaAs c удельным электросопротивлением 10 10 …10 11 Ом·м (рис. 1.39, а).
В подзатворную область на глубину d к=0,05…0,2 мкм проводится имплантация донорной примеси до концентрации Nd =10 23 м -3 . Величина dк определяется требуемым значением контактного напряжения канала Uк:
 , (1.69)
, (1.69)
где ε≈13,1 – диэлектрическая проницаемость GaAs.

Области истока и стока легируются до концентрации донорной примеси n + =10 24 м -3 . Невыпрямляющие (омические) контакты к областям истока и стока выполняются из сплава Au — Ge . Барьер Шоттки создается за счет напыления на поверхность кристалла сплавов Ti — W , Si — W , или металлов Mo , Ti , Pt , Au . Эти материалы характеризуются довольно высоким значением напряжения барьера Шоттки Uбш≈0,8 В. Напряжение запирания (отсечки) ПТШ, U, определяется из выражения
 . (1.70)
. (1.70)
Знак напряжения отсечки у ПТШ может быть как положительным, так и отрицательным и определяется величиной контактного напряжения U к.
Пример. Определить напряжение запирания (отсечки) U при значениях d к =0,05 мкм и d к =0,2 мкм. Принимая Uбш=0,8 В, n=10 23 м -3 , ε≈13,1, получаем при d к =0,05 мкм значение U =+0,6 В. При d к =0,2 мкм получим отрицательное значение U =-2 В. В практических случаях величина U для G aAs транзисторов может лежать в пределах от +0,2 В до -2,5 В.
Статические характеристики ПТШ представлены на рис. 1.40, а и б. Если U>0 (обычно +0,2 В), то при U зи=0 канал перекрыт запирающим слоем с сопротивлением ρ=10 8 …10 9 Ом, и транзистор называют нормально закрытым (НЗ) ПТШ. Если U U зи=0 канал является проводящим, и такой транзистор называют нормально открытым (НО) ПТШ (рис. 1.40, а). В данном случае обогащенный электронами канал получается за счет создания поверхностных состояний на границе затвор – эпитаксиальный слой.
Особенностью работы ПТШ является то, что при Uзи ≥Uбш ПТШ переходит в режим затворного тока, когда в цепи затвор-исток ПТШ протекает ток затвора Iз, в результате чего ток стока Iс достигает насыщения (рис. 1.40, а).

Максимальный ток стока I c max в этом случае определяется из выражения
 ≈0,4…5 мА, (1.71)
≈0,4…5 мА, (1.71)
где b ≈(1…2) мА/В 2 – удельная крутизна; U – пороговое напряжение (напряжение отсечки), взятое с соответствующим знаком.
При этом максимальное напряжение между затвором и истоком определяется из выражения
 , (1.72)
, (1.72)
Выходные (стоковые) характеристики ПТШ показаны на рис. 1.40, б. Характеристики имеют вид, обычный, для полевых транзисторов, то есть имеют линейный участок и участок насыщения. Границей между двумя областями является напряжение насыщения Uсн=0,1…0,2 В для НЗ ПТШ, Uсн=0,5…0,8 В для НО ПТШ. Значение тока насыщения стока Iсн определяется на основании выражения (1.26):
 .
.
Транзистор Шоттки — электронный компонент, представляющий собой комбинацию из биполярного транзистора и диода Шоттки.
Содержание
Устройство [ править | править код ]
Транзистор Шоттки получается подключением диода Шоттки между базой и коллектором биполярного транзистора, причём для создания n-p-n транзистора Шоттки к биполярному n-p-n транзистору подключается диод Шоттки анодом к базе, а катодом к коллектору, а p-n-p транзистор Шоттки — подключением к биполярному p-n-p транзистору диода Шоттки катодом к базе и анодом к коллектору.
Диод Шоттки, благодаря своим свойствам обладает меньшим напряжением между анодом и катодом в открытом состоянии по сравнению с кремниевым диодом (0,2-0,3 В против 0,5-0,7 В) и его включение между базой и коллектором биполярного транзистора препятствует вхождению в насыщение в открытом состоянии — фактически здесь диод Шоттки осуществляет отрицательную обратную связь (ООС): чем сильнее открывается транзистор, тем больше уменьшается потенциал коллектора относительно земли и относительно базы, при этом увеличивается ток, протекающий через диод Шоттки, отводя базовый ток на землю и фиксируя напряжение база-коллектор на уровне 0,2-0,3 В, в открытом состоянии транзистор Шоттки находится в промежуточной области между активным режимом и насыщением, таким образом препятствуя двойной инжекции и накоплению зарядов, исключая задержку во времени, связанную с рассасыванием избыточных носителей при переключении из открытого в закрытое состояние. Кроме того сам диод Шоттки имеет высокое быстродействие при переходе из открытого в закрытого состояние, поскольку в нём нет процессов накопления носителей и все процессы не связаны с диффузией, а обусловлены только дрейфом в электрическом поле. В закрытом состоянии транзистора напряжение анод-катод диода смещает последний в обратное направление и никак не влияет на работу транзистора.
Применение [ править | править код ]
Транзистор Шоттки применяется в микросхемах транзисторно-транзисторной логики Шоттки (ТТЛШ), при этом быстродействие ТТЛШ гораздо выше обычной ТТЛ с многоэмиттерным транзистором.
Обозначение на схемах [ править | править код ]
Транзистор Шоттки на электрических принципиальных схемах имеет самостоятельный символ, который используют обычно вместо комбинации обозначений биполярного транзистора и диода Шоттки.
Биполярный транзистор в цифровых ИС обычно выполняет функцию ключа и всё время работает либо в режиме насыщения, либо в режиме отсечки. В режиме насыщения происходит накопление неосновных носителей заряда в базе транзистора, а также в коллекторной области. Процессы накопления неосновных носителей и их последующего рассасывания при переводе транзистора в режим отсечки или в выключенное состояние связаны с относительно медленным процессом диффузии неосновных носителей заряда. Инерционность этих процессов определяет скорость переключения транзистора из включённого состояния в выключенное и обратно, т.е. скорость срабатывания схемы.
Для ускорения процесса накопления и рассасывания неосновных носителей заряда целесообразно ограничить их накопление. Достичь этого можно путём шунтирования коллекторного перехода транзистора диодом Шоттки, т.е. диодом с выпрямляющим переходом между металлом и полупроводником. Структура такого интегрального транзистора и его эквивалентная схема показаны на рис.3.11.
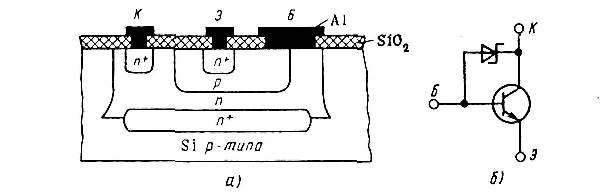
Рис.3.11. Структура транзистора с диодом Шоттки (а) и его эквивалентная схема(б)
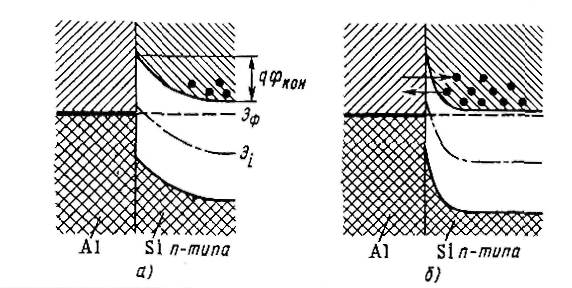
а- выпрямляющего перехода между алюминиевым электродом и высокоомной n-областью коллектора; б- омического перехода между алюминиевым электродом и сильнолегированной n + -областью эмиттера кремниевого транзистора
Алюминиевый электрод образует с p-областью базы омический контакт, а переход между алюминиевым электродом и относительно высокоомной n-областью получается выпрямляющим. Из-за неравенства работ выхода электронов из алюминия и из кремния с электропроводностью n-типа и в результате химической обработки поверхности кремниевого кристалла на контакте для электронов возникает потенциальный барьер высотой около 0,6эВ (рис.3.12а), что несколько меньше высоты потенциального барьера на коллекторном переходе. Поэтому при прямом смещении коллекторного перехода и соответственно при прямом смещении диода Шоттки основная часть прямого тока коллектора будет проходить через диод Шоттки. Этот ток связан с движением электронов из n-области коллектора в металлический электрод и не сопровождается инжекцией дырок в n- область коллектора. Таким образом, в высокоомной области коллектора практически не происходит накопления неосновных носителей заряда. Кроме того, из-за меньшей высоты потенциального барьера на барьере Шоттки по сравнению с высотой потенциального барьера на коллекторном переходе при тех же прямых токах коллектора на коллекторном переходе будет меньшее прямое напряжение, что соответствует меньшему количеству накопленных неосновных носителей заряда в базе транзистора при режиме насыщения (рис.3.13). В результате время рассасывания в транзисторе с диодом Шоттки оказывается значительно меньшим (несколько наносекунд), чем время рассасывания в транзисторе аналогичной структуры, но без шунтирующего диода Шоттки.

Рис.3.13. Распределение концентрации неосновных носителей заряда в различных областях транзистора при его работе в режиме насыщения:
а — в структуре обычного планарного транзистора;
б — в структуре аналогичного транзистора с диодом Шоттки, включённым параллельно коллекторному переходу
На контакте алюминиевых электродов с сильнолегированными n + — областями эмиттера и коллектора также могут возникать потенциальные
барьеры, но их толщина оказывается настолько малой, что сквозь такие узкие потенциальные барьеры электроны могут проходить практически беспрепятственно путём туннелирования (рис.3.12б). Таким образом, на контактах алюминиевых электродов с эмиттерной областью и с сильнолегированной частью коллекторной области получаются омические контакты, а их формирование и формирование выпрямляющего контакта Шоттки осуществляется во время одного процесса металлизации.
Изготовление интегрального транзистора с диодом Шоттки не требует введения дополнительных технологических операций. Необходимо лишь изменить соответствующим образом фотошаблон, применяемый при проведении фотолитографии для снятия диоксида кремния под контакты, и расширить слой напыляемого алюминия за металлургическую границу коллекторного перехода. При снятии диоксида кремния в месте выхода коллекторного перехода на поверхность монокристалла кремния и при обработке этой поверхности перед нанесением алюминиевой металлизации следует предотвратить возможность загрязнения pn-перехода коллектора неконтролируемыми примесями.
Структурное решение, показанное на рис.3.11, можно использовать не только в простейшем транзисторе, но и в МЭТ. В обоих случаях отсутствуют накопление и рассасывание избыточных зарядов и получается существенный (в 1,5-2раза) выигрыш во времени переключения транзисторов из полностью открытого в запертое состояние.
Дата добавления: 2016-04-02 ; просмотров: 1819 ; ЗАКАЗАТЬ НАПИСАНИЕ РАБОТЫ

.JPG/220px-3%D0%98-%D0%9D%D0%95_74LS(%D0%9A555).JPG)


Отправить ответ